Inductively-Coupled Plasma Etching (ICP)
Responsibility:
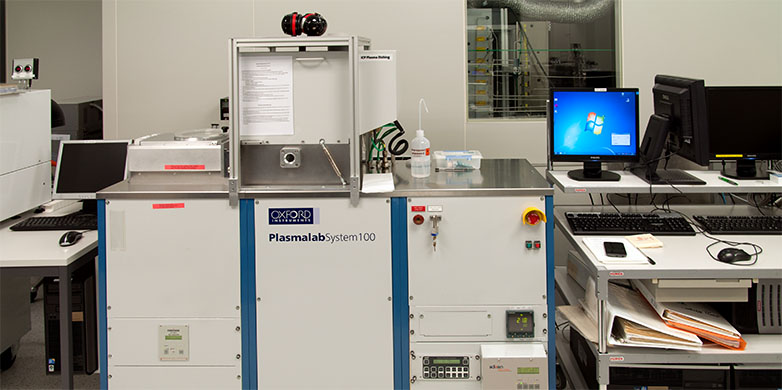
Oxford Instruments ICP 180
- Plasma assisted etching of III-V semiconductor materials
- Samples form 6x6mm on 4” Si-carrier up to 4“ wafer
- Base pressure 6x10-7 Torr
- Temperature controlled Stage –150°C to 400°C
- CH4, H2, Cl2, CF4, SF6, O2, Ar, and N2
SiCl4 available after special introduction by responsibles
- RF 13.56 MHz 500W source
- ICP 13.56 MHz 3 kW source
- Load lock with automatic transfer
The ICP system is mainly dedicated for anisotropic etching of InP, GaAs and its quaternary materials. It is equipped with the neccessary gas sources to run the common standard reciepes for these compound semiconductors. The coil around the chamber allows to inductively couple energy to the plasma, allowing a more dense plasma to form.
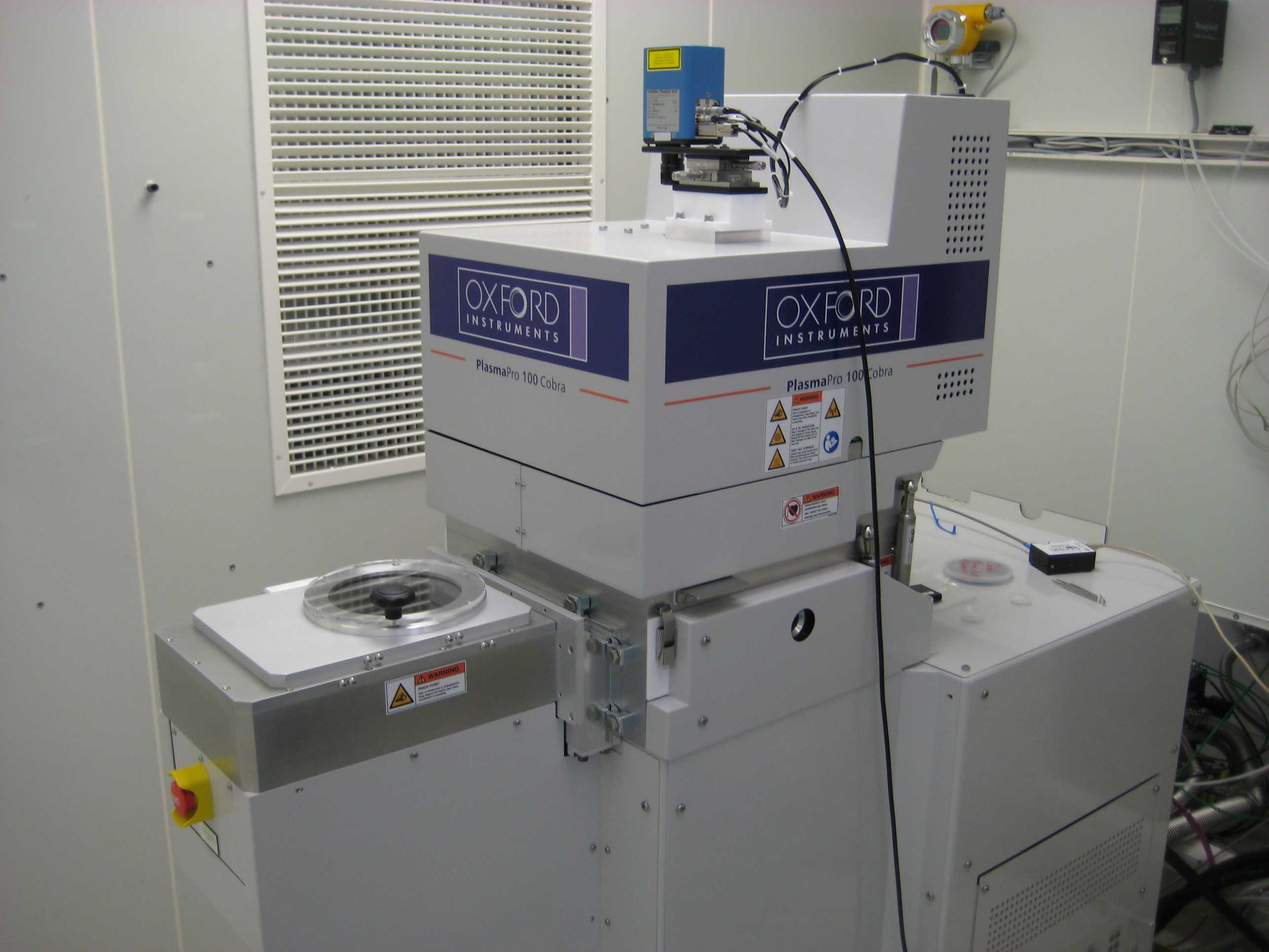
Oxford Instruments PlasmaPro 100
This ICP is especially suited for etching diamond and oxides. Features like chiller, wall heating, in-situ wafer temperature monitoring, and two independent endpointing systems allow for reproducible and reliable processes. A large and homogeneous plasma volume allows for 4” and 6”
wafer, also small parts possible.
- Endpoint detectors:
Interference: for transparent masks and substrates
Absorption (70-µm wide spot)
Spectrometer for absorption/emission lines - Chiller (-20 to 80 deg)
- Wide range substrate electrode (-20 to + 400 deg)
- Wall heating for consistent chamber conditions
- In-situ wafer temperature probe
- Gases: Cl2, SF6, CHF3, O2, Ar, N2,He, 1 spare
